QFN(方形扁平無引線)封裝因其卓越的電熱性能、緊湊的結(jié)構(gòu)和輕量化特點,已成為高密度電子組裝的首選之一。然而,QFN器件的SMT貼裝工藝卻面臨諸多挑戰(zhàn),如何通過科學(xué)的焊盤設(shè)計和嚴(yán)格的焊接質(zhì)量控制實現(xiàn)高良品率,成為電子制造企業(yè)的核心競爭力。
QFN封裝的特點與工藝挑戰(zhàn)
QFN(Quad Flat No-lead)封裝是一種典型的底部焊端封裝元件,其特點是焊端除焊接面外嵌在封裝體內(nèi),與PCB上對應(yīng)的焊盤構(gòu)成“面-面”連接的結(jié)構(gòu)特點。
這種結(jié)構(gòu)帶來了幾個顯著的工藝挑戰(zhàn):
-
焊膏量與焊縫面積呈正比:焊膏量越多,焊縫擴展面積越大,越容易發(fā)生橋連
-
熱沉焊盤上的焊膏量決定了焊縫高度:熱沉焊盤面積通常比所有信號焊端的面積總和還要大
-
熱沉焊盤容易出現(xiàn)大面積空洞:大尺寸焊盤結(jié)構(gòu)使焊接時焊膏中大量溶劑難以揮發(fā),容易形成空洞
此外,QFN器件在回流焊接過程中極易產(chǎn)生底部熱沉焊盤焊接空洞、器件引腳間錫珠和橋連等缺陷,當(dāng)多個QFN器件同時焊接時,缺陷發(fā)生率顯著提高。

QFN焊盤設(shè)計的核心要素
外圍I/O引腳焊盤設(shè)計
PCB板上I/O的焊盤應(yīng)設(shè)計為比QFN的I/O焊接端略大。焊盤內(nèi)側(cè)應(yīng)設(shè)計成圓形以與焊盤形狀相適應(yīng)。通常情況下,電路板上I/O焊盤的周長至少應(yīng)超出0.15mm,而內(nèi)部持續(xù)長度至少應(yīng)為0.05mm,以確保QFN周圍焊盤與中心部分焊盤之間有足夠空間,防止橋接發(fā)生。
PCB阻焊設(shè)計
QFN的阻焊設(shè)計主要分為兩種類型:SMD(阻焊定義) 和NSMD(非阻焊定義)。NSMD技術(shù)的銅腐蝕過程更易于控制,允許將焊膏放置在金屬焊盤周圍,大大提高焊接連接的可靠性。
對于面積較大的中央散熱焊盤,阻焊設(shè)計則推薦采用SMD技術(shù)。阻焊層開口應(yīng)比焊盤大120-150μm,即阻焊層與金屬焊盤之間應(yīng)保持60-75μm的間距。
中央散熱焊盤與通孔設(shè)計
中央散熱焊盤的設(shè)計直接影響QFN器件的散熱性能和焊接質(zhì)量。為了有效將IC內(nèi)部熱量傳導(dǎo)到PCB板,PCB底部必須設(shè)計相應(yīng)的導(dǎo)熱墊和散熱通孔。
通孔設(shè)計需注意:
-
通孔數(shù)量與尺寸取決于封裝應(yīng)用領(lǐng)域、IC功率范圍和電氣性能要求
-
阻焊層應(yīng)覆蓋焊盤上的散熱通孔,防止焊膏流出導(dǎo)致空焊
-
通孔阻焊層直徑應(yīng)比通孔直徑大100μm
-
建議在PCB背面涂阻焊油堵塞通孔,利于回流焊過程中氣體釋放

鋼網(wǎng)模板優(yōu)化設(shè)計策略
外圍I/O焊盤開孔設(shè)計
金屬鋼網(wǎng)開孔設(shè)計通常遵循面積比和寬厚比原則。對于QFN器件,外圈鋼網(wǎng)開窗長度方向應(yīng)向封裝外擴展,特別是與大銅皮連接的焊盤,外擴至少0.5mm以上,以確保足夠的焊膏量。
中央散熱焊盤開孔設(shè)計
中央散熱焊盤屬于大尺寸設(shè)計,焊接時氣體不易逸出易產(chǎn)生氣泡。為減少氣孔數(shù)量并獲得最佳焊膏耗散,應(yīng)采用網(wǎng)格式漏孔陣列替代單一大型開口。
每個小開口可以設(shè)計成圓形或方形,焊膏涂敷量應(yīng)控制在50%-80%范圍內(nèi)。這種設(shè)計既能保證足夠的焊接面積,又能為氣體逸出提供通道,顯著減少空洞率。
模板類型與厚度選擇
模板類型與厚度直接影響焊膏涂敷厚度,進而決定組裝元件的連接高度。對于細間距QFN器件,通常選擇厚度0.1-0.12mm的鋼網(wǎng),依據(jù)焊盤尺寸和間距進行精確開孔。
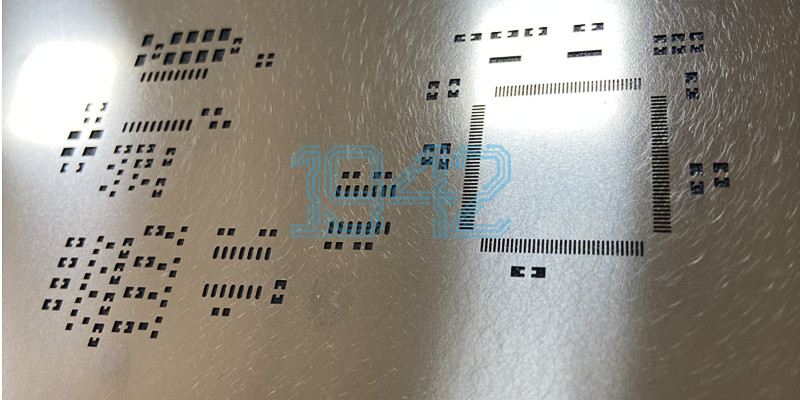
QFN焊接工藝質(zhì)量控制
焊接缺陷分析與預(yù)防
橋連:多見于雙排QFN的內(nèi)排焊點間,主要因焊料被擠到非潤濕面而形成。解決方案包括減少內(nèi)圈焊膏印刷量,縮短內(nèi)圈焊盤開窗長度。
虛焊:可能由多種因素引起,包括:
-
少錫導(dǎo)致的虛焊
-
芯吸效應(yīng)導(dǎo)致的虛焊(焊盤與大銅皮連接時)
-
類球窩機理導(dǎo)致的虛焊(熱沉焊盤存在大型空洞)
-
引腳焊點內(nèi)大空洞導(dǎo)致的虛焊
-
QFN單邊翹導(dǎo)致的虛焊
錫珠:產(chǎn)生于器件引腳間,通常通過優(yōu)化焊盤工藝設(shè)計、鋼網(wǎng)模板設(shè)計和焊接溫度曲線來控制。
回流焊溫度曲線優(yōu)化
回流焊溫度曲線對QFN焊接質(zhì)量至關(guān)重要。QFN焊點形成過程中,通常是周邊焊點先于熱沉焊盤熔化,聚集并將QFN暫時浮起。
隨著熱沉焊盤上焊膏熔化并潤濕QFN熱沉焊盤表面,QFN又被拉下(塌落過程)。QFN尺寸越大,這一過程越明顯,因此回流焊接時間長短對焊接良率影響很大。
優(yōu)化的溫度曲線應(yīng)確保:
-
適當(dāng)?shù)念A(yù)熱速率,避免熱沖擊
-
足夠的恒溫時間,使焊膏中溶劑充分揮發(fā)
-
準(zhǔn)確的回流峰值溫度,保證焊料充分熔化而不損傷元件
-
可控的冷卻速率,形成可靠的焊點結(jié)構(gòu)
先進檢測與質(zhì)量監(jiān)控
對于QFN焊點質(zhì)量檢測,需采用多種方法結(jié)合:
-
光學(xué)檢測:適用于單排QFN,通過焊點潤濕狀態(tài)、有無裂紋等判定
-
X射線檢測:對于雙排QFN,可通過檢測少錫推斷是否虛焊
-
染色測試:準(zhǔn)確定位虛焊位置
-
切片分析:深入分析焊點內(nèi)部結(jié)構(gòu)和缺陷成因
總結(jié)
QFN器件的SMT貼裝是一項系統(tǒng)工程,需從焊盤設(shè)計、鋼網(wǎng)開孔、焊膏印刷到回流焊整個工藝鏈進行精確控制。通過科學(xué)的DFM(面向制造的設(shè)計)原則、嚴(yán)格的工藝參數(shù)控制和全面的檢測手段,可以顯著提升QFN器件的一次裝配良率,減少錫珠、虛焊和橋連等缺陷。
作為專業(yè)的SMT貼片加工廠,我們始終致力于精密焊接工藝的研究與應(yīng)用,通過微米級精度的工藝控制,為客戶提供高可靠性的電子制造服務(wù)。歡迎有SMT貼片加工需求的客戶聯(lián)系我們,共同探討您的項目需求。








 2024-04-26
2024-04-26